UTACグループは、半導体業界の独立系大手企業です。集積回路の組み立てやテストに関する高度な技術で、世界中の顧客に幅広く、テスト開発、エンジニアリング、製造などのサービスやソリューションを提供している業界のリーディングカンパーニーです。
IC業界は、常により小型のフットプリントによる薄型パッケージ開発に挑戦しています。フリップチップ パッケージの使用量は、高い入出力と、拡張性能、そして小型フォームによってここ数年、顕著に増加を続けています。
フリップチップ技術は、他の高密度電子パッケージの試みと比べて様々な利点がありますが、金型化を保障することや、フリップチップ技術の急速な進歩(バンプピッチを減らすこと、スタンドオフ高、パッケージの薄さ、MUF材)によって欠陥を最小限に抑える必要があります。
これらの要因そのものと、これらがパッケージの歩留まりや信頼性、パフォーマンスに及ぼすインパクトが相互に影響を及ぼし合い、複雑さを増しています。例えば、気泡侵入の課題はダイの下のバンプ領域の小ギャップの増加に直面していますが、これが結果的にメルトフロントの不均衡や流動抵抗を引き起こしています。
UTACでは、Moldex3Dをバーチャル金型試作ラボのツールとして2009年から採用しており、数々のプロジェクトでの成功例があります。
「我々は、Moldex3Dを量産段階で直面している数々の問題解決に活用していくつもりだ。大規模なDOE(実験計画法)の計画マトリクスを伴う実験は、金型の問題解決に良く使用されているが、それは、流動、伝熱、そして、封止材の重合などが複雑に及ぼし合う影響のため、時間の浪費になっている。数値シミュレーションは、複雑な物理現象を解析する有効なツールである」と チームリーダーのOre Sie Hoon氏は語っています。
つい先日、これに関するUTACグループの技術報告書は、第44回IMAPS国際シンポジウムにて最優秀論文として表彰されました。
PDFは、コチラからご参照ください。
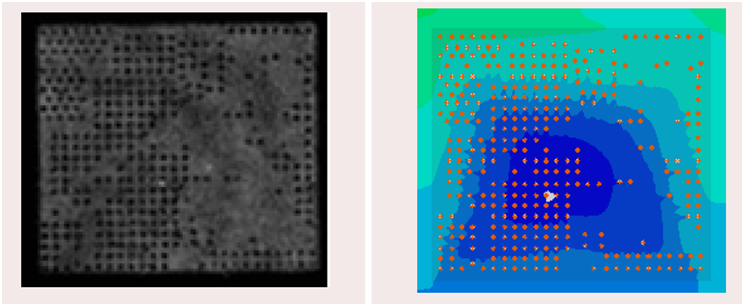 The validation shows Moldex3D accurately predicts the air entrapment in the molded underfill package.
The validation shows Moldex3D accurately predicts the air entrapment in the molded underfill package.