IC Insights’ 2012 McClean Reportには、 “ICのアセンブリとパッケージは、もはやフロントエンド処理を無視できません。封止成形は、単純なクッキーカッタータイプの技術から、非常に高度でカスタマイズされたソリューションまで進化しました” と書かれています。おそらくこれは、最近の業界傾向に見られるように、半導体メーカーがICパッケージ業界に参入し、3次元ICの人気拡大を期待していることを反映しているのだと思います。事実、ICパッケージ分野への資本支出はますます増大しています。
ウェーハーレベルのICパッケージ技術がもたらす利益が期待されているため、昨今の半導体の製造工場では、3次元 IC工程にかなりの人材投入と研究投資を行っています。マイクロチップの需要が世界的に高まっているため、従来の半導体デバイス製造会社も同様に、3次元ICパッケージ工程に注目しています。
3次元ICパッケージには次のような多くの利点があります。チップの高性能性、高機能性、消費電力の削減、記録容量の向上、帯域幅の拡大、チップサイズの縮小化など。しかし成形工程では熱(温度)と信頼度において克服すべき課題があります。例えば、エポキシ樹脂成形コンパウンドはIC封止成形技術においてシリコンチップ、はんだバンプ、ワイヤボンド、リードフレーム、パドルを保護するために使用されますが、これが構造的な欠陥を引き起こすことになりかねません。
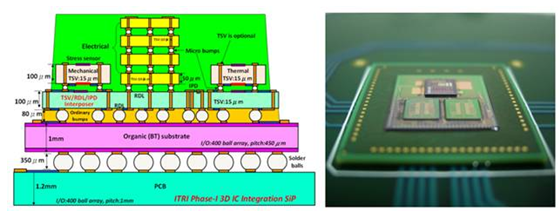 図. 1 3D IC構造の図解. Image source : ITRI, Electronics and Optoelectronics Research Laboratories.
図. 1 3D IC構造の図解. Image source : ITRI, Electronics and Optoelectronics Research Laboratories.
Moldex3Dは今日まで、実際のIC封止成形工程の課題に対する解決策を開発、提供してきました。 Moldex3D 封止成形解析 はワイヤースイープ、残留応力、ボイドなどを正確に予測できます。3次元ICパッケージ業界に対する需要の高まりに応え、Moldex3D はフリップチップ成形シミュレーションをパッケージ成形のシミュレーションの強力なツールとして開発しました。(図2参照)狭ピッチフリップチップ工程における課題(耐衝撃性、反応性ポリマーメルトとマイクロチップコンポーネント間の複雑な相互作用によって実際のアンダーフィル工程で発生するボイドなど)は、Moldex3D シミュレーションの熱伝達、構造変形、マイクロチップのアンダーフィルのキュアリング動力学と簡単に区別されます。アンダーフィルの表面張力やバンプと基板の接触角度に影響を受ける毛細管流挙動(図3)と、吐出工程は完全に数値解析で考慮されます。Moldex3D 封止成形解析は、どのようにして封止材料がギャップに充填され、バンプ周囲を流動するか、また射出装置の速度の影響を表示します。このような複雑な物理現象を理解するために多くの時間を費やす必要はなくなりました。Moldex3D のシミュレーション機能を利用すれば、工程設計者はICパッケージ成形工程に確信を持ち、高性能に実行できます。
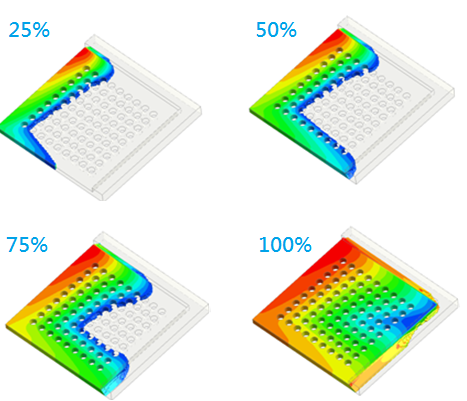 図 2 毛細管アンダーフィルのフローフロントシミュレーション
図 2 毛細管アンダーフィルのフローフロントシミュレーション