Moldex3D ICチップパッケージングソリューション概要
Download IC Packaging Brochure >
ICパッケージングとは、物理的損傷や腐食を防止するためにICチップをエポキシ樹脂材料(Epoxy Molding Compound, EMC)で封止する工程を指します。パッケージングのプロセスには、ICチップとその他の電子部品(ワイヤ・ボンディング)、熱硬化性材料の硬化反応、パッケージングプロセス条件制御の相互作用が含まれます。ICチップパッケージングには、エポキシ樹脂(EMC)、シリコンウエハー、リードフレーム、高密度ワイヤーなどの複雑な部品が多く含まれており、そのプロセスにおいて様々な課題と不確定要素が発生します。ICパッケージングにおける一般的な問題としては、不完全充填、空孔、ワイヤースイープ、パドルシフト、そり変形などがあります。
Moldex3D ICチップパッケージングモジュールでは、トランスファー成形、キャピラリーアンダーフィリング(CUF)、圧縮成形、半導体埋め込み基板(EWLP)、ノーフローアンダーフィル(NUF)/非導電性樹脂(NCP)プロセスを含む体系的なソリューションを提供します。メッシュ生成において、ユーザーはオートメッシュ生成を選択することで簡単にプロジェクトの設定を行うことができます。また、より複雑な組み立てに対しては、マニュアルによるメッシュ生成を選択して(例:リードフレームと積層シリコンウエハー)プロジェクトの設定を行うこともできます。
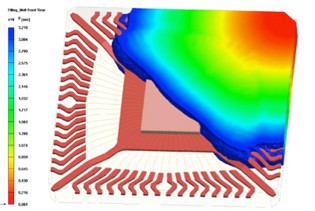 |
|
|
メルトフローの様子 |
ワイヤースイープシミュレーション–ワイヤスウィ-プ量とスイープ前後のワイヤーの比較 |
Moldex3D ICチップパッケージングモジュールでは、基本的なEMCフローと硬化プロセスのシミュレーションを除き、ほぼすべての解析項目をサポートしています。またその他の先進的な製造プロセス評価も行っています。(例:充填材の比較、アンダーフィルパッケージング、ポスト・モールドキュアプロセス、応力分布、構造変形など)精確なシミュレーションにより成形上の深刻な問題を予測・解消することができ、製品品質の向上に役立ちます。また、潜在的な製品不良の発見にも力を発揮し、設計の最適化、製造コストの削減、製造サイクルの短縮を実現します。
