ICパッケージングにおけるキャピラリーアンダーフィル(CUF)プロセスでは、フリップチップの側面にエポキシ樹脂を塗布し、表面張力を利用してフリップチップの底部を充填します。Moldex3D IC Packaging module は、このキャピラリーアンダーフィル解析に対応しており、主にキャピラリーフローの解析を行います。
充填プロセスにおいて、エポキシ樹脂のフローフロントは、基板(PCB)、はんだボール、シリコンダイなどの複数の材料の部品と接触します。接触面における表面張力特性は、接触する成分によって異なります。Moldex3Dでは、表面張力特性を考慮することで、より実際に近い解析結果を得ることができます。接触する成分ごとに、エポキシ樹脂との接触角度をパラメーターとして設定できます。
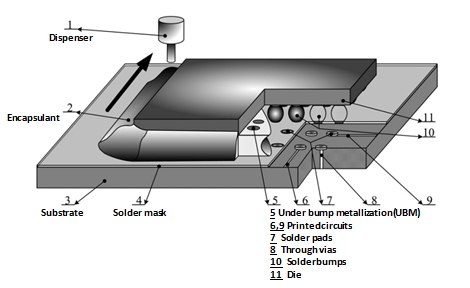
Flip-chip capillary underfilling process
操作手順 - インサート部品ごとに異なる接触角を設定
Step 1 ICチップパッケージング解析プロジェクトを作成し、キャピラリーアンダーフィルモデルをインポートします。本事例では、次の4つのインサート部品にエポキシ樹脂が接触します:はんだボール、シリコンダイ、銅パッド、SI貫通電極(TSV)。
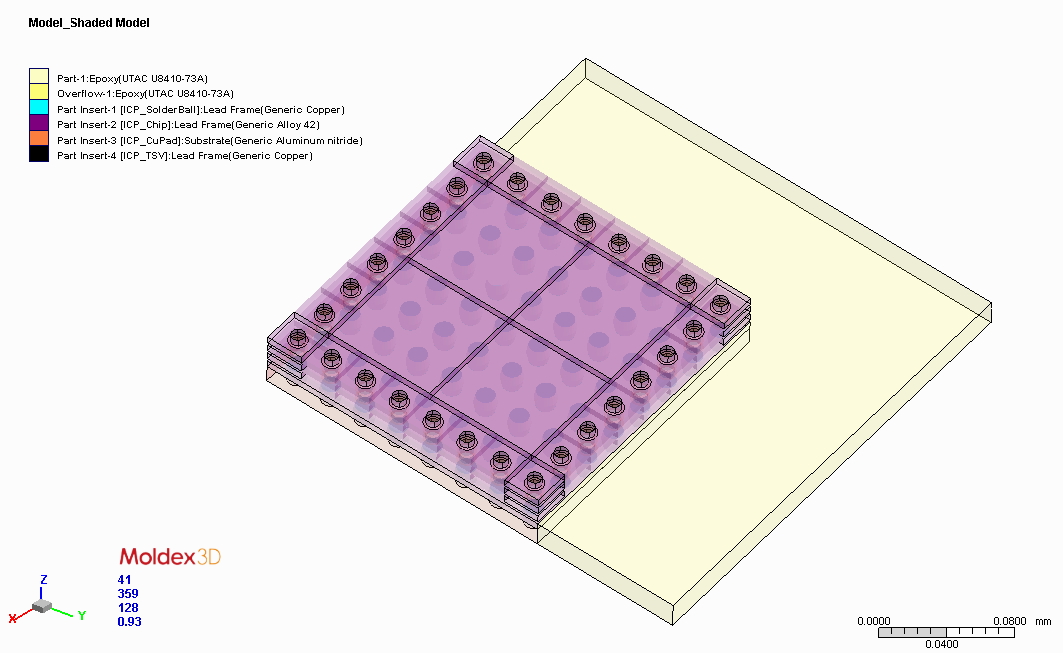
キャピラリーアンダーフィルの事例
Step 2 プロセスウィザードを開き、Analysis type(解析タイプ)からCapillary Underfill(キャピラリーアンダーフィル)を選択、Underfill Setting(アンダーフィル設定)タブのAdvanced(詳細設定)をクリックします。Surface Tension(表面張力)タブに切り替え、エポキシ樹脂の表面張力係数と、各インサート部品との接触角度を指定します。
プロセスウィザードの設定画面
Step 3 そのほかのプロジェクト設定が完了し、フロー解析を実行すると、各接触角設定がメルトフロントへ与える影響を確認できます。本事例では、次の3組の異なる設定を適用しています。A:接触角をすべて30度に設定、B:接触角をすべて10度に設定、C:接触角をそれぞれ異なる角度に設定。解析結果から、接触角設定がメルトフロント予測に大きく影響し、充填の傾向が大きく変化することがわかります。