ICやICパッケージ、プリント基板の設計作業を支援するEDAツール(Electronic Design Automation/電子設計自動化ツール)は、回路基板設計、相互接続設計、メタルフィル生成などに活用されており、一般的には2Dです。 複雑かつ高密度の設計が求められる近年のICパッケージでは、3D設計と解析によってより現実的な設計や管理、多階層のワイヤボンドダイやスタックトダイの設計が行わるようになってきています。
ケイデンス社の Cadence® Connections™ EDA Programは、世界各国のサードパーティソフトウェアとの連携し、ケイデンス社製品を利用するユーザーのメリット拡大を推進してきました。Cadence® Connections™ EDA Programは、フロントエンド設計、IC搭載、IP試験、混合信号、評価、生産性、システムパッケージ基盤などにおける補助ソリューションを提供するサプライヤーの支援を行うプログラムです。今回、ICパッケージ生産過程における封止の物理的な状態を正確に可視化するにあたり、ケイデンス社とコアテックシステム社はEDAツールとMoldex3Dの連携に取り組みました。 この連携によって、ICパッケージ設計時に3Dビューの自由な拡大・移動・回転が可能になりました。
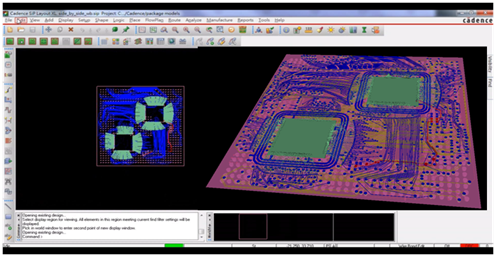 Fig. 1 Cadence EDA ツールによるICパッケージ設計の可視化
Fig. 1 Cadence EDA ツールによるICパッケージ設計の可視化
Moldex3D ICパッケージ解析は、革新的かつプロフェッショナル向け3Dシミュレーション技術を用いて、Cadence EDA ツールユーザーのパッケージ設計から生産までの工程を強力に支援します。Cadence EDAツールと Moldex3D を連携させることで、複雑なICパッケージの設計においてMoldex3D Designer と Moldex Mesh の .3diファイルインポートが可能になります。 Moldex3Dプリプロセッサーにすべてのコンポーネントがインポートされると、パッケージ全体のジオメトリを可能な限り単純化したメッシュが効率的に自動生成されます。 さらに、精密な操作が求められるICワイヤについてはパラメーター調整機能が実装されており、メッシュ準備に要する時間と労力を大幅に節約できます。
また、Moldex3Dは、キュアリング処理の前後にエポキシ樹脂封止材料に生じる粘性変化等の非線形性を考慮した樹脂流れの計算に対応しています。成形に関する問題の多くは事前の予測と解決が可能です。これにより、チップ品質の向上と不良品の発生確率の低減を実現します。

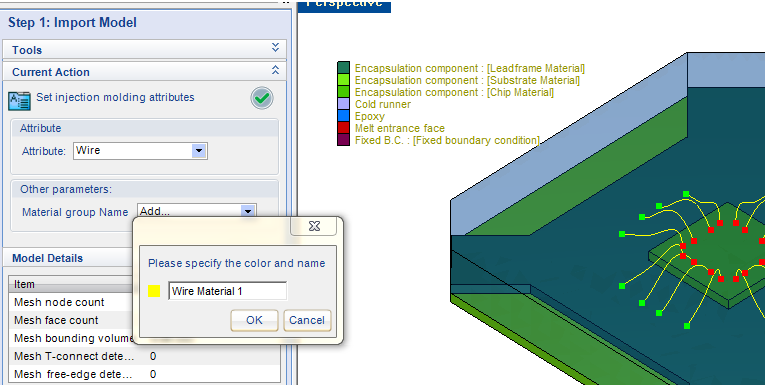 Fig. 2 Moldex3Dプリプロセッサの精密ICワイヤの3diファイルインタフェースとパラメーター調整機能
Fig. 2 Moldex3Dプリプロセッサの精密ICワイヤの3diファイルインタフェースとパラメーター調整機能
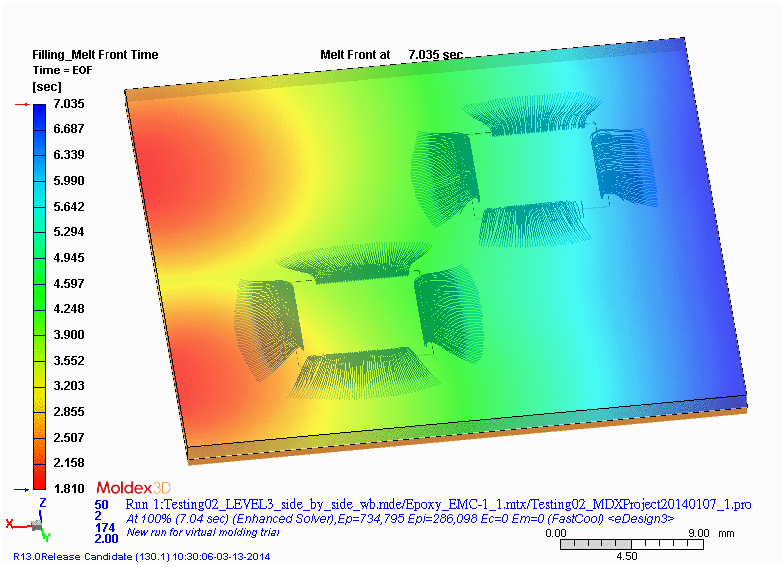 Fig. 3 Moldex3D IC Packagingの三次元解析結果可視化機能と成形不良予測
Fig. 3 Moldex3D IC Packagingの三次元解析結果可視化機能と成形不良予測
[1] https://www.cadence.com/products/pkg/3d_design_viewer/pages/default.aspx[2] https://www.youtube.com/watch?v=nj3ltW7Ax1c