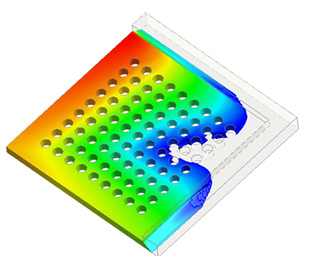
なぜアンダーフィルシミュレーションを使用するのでしょう?
Moldex3DのICチップパッケージングアンダーフィルモジュールでは、キャピラリフロー計算をサポートしています。ICチップと基板とのギャップは表面張力を利用して封止しますが、エポキシ樹脂とその他の部品との接触角度により表面張力は異なります。
一般的にフリップチップの熱膨張係数は比較的低く、熱循環において変形しやすく、過度の変形はICチップの機械的疲労、性能不良、破断などの問題につながります。そのため、アンダーフィルシミュレーションは、フリップチップ開発の品質と信頼性の向上を目的として開発されました。
課題
- 表面張力作用の精確な分析
- エポキシ樹脂のメルトフロントの安定性予測
Moldex3Dのソリューション
- ICチップと基板間との毛細管現象の可視化
- 動的なディスペンサープロセスの充填挙動の可視化
- ディスペンサーパラメータ設定およびエポキシ樹脂とその他ユニットとの接触角の解析
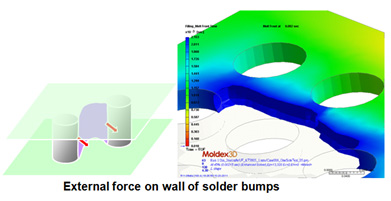
- はんだ間の距離とパターン配置図のフリップチップ充填への影響を評価
- エアトラップの位置の予測と充填で生じる潜在的な不良の防止
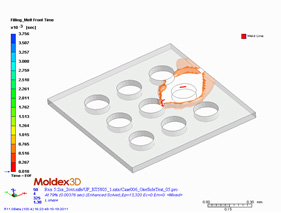
- 成形の最適化とコストの削減を実現
業界への応用
ICパッケージング産業
Moldex3Dの推奨製品
Moldex3D Advanced Package